 |
Главная |
Электростатическая ионизация
|
из
5.00
|
(туннельный эффект или эффект Зинера)
В отсутствие электрического поля переход электронов из валентной зоны в зону проводимости, возможен лишь после преодоления энергетического барьера, ширина которого равна ширине запрещенной зоны Eg, т.е. вдоль вертикальной оси энергий на рис. 3.15 а.
Если к кристаллу приложить сильное электрическое поле, то происходит наклон энергетических зон (рис. 3.15, б). Из рисунка видно, что в присутствии очень сильного электрического поля, дно зоны проводимости и потолок валентной зоны могут пространственно сблизится настолько, что появляется возможность горuзонтальнго (перпендикулярно оси энергий) перехода электрона из валентной зоны в зону проводимости. При таком переходе в отличие от верmикального перехода AàC энергия электрона до и после перехода остается неизменной. В таком переходе электрон как бы проходит вдоль пути АàВ под энергетическим барьером АВС. Это так называемый туннельный эффект. Аналогичное явление имело место при образовании зон по модели Кронига-Пенни, где прозрачность барьера характеризуется величиной 1/P (см. раздел. 1.3.3 и формулу (1.68))
| E C EC Eg EV A E1 (a) 0 x | E C B A EC E2 EV (б) 0 x |
| Рис. 3.15. Зонная структура нелегированного полупроводника в: (а) – слабом (E1) и (б) – сильном (E2) электрических полях (для иллюстрации эффекта Зинера). |
Вероятность туннельного перехода зависит от высоты потенциального барьера АС, равной ширине запрещённой зоны, и его ширины АВ. Как видно из рис. 3.15, расстояние АВ (ширина барьера для туннелирования) уменьшается с увеличением E. Эффективная ширина барьера ∆х=АВ может быть определена из разности потенциальной энергии электрона в зоне проводимости в точке В, а в валентной зоне – в точке А.
Так как U(В) - U(А) = - q E∆х = - ∆Eg c точностью до аддитивной постоянной, то эффективная ширина барьера будет: Δx=ΔEg/q E, т.е. ширина потенциального барьера обратно пропорциональна напряжённости электрического поля.
Переход электрона из точки А в точку В связан с переходом сквозь треугольный потенциальный барьер АБВ. Как известно из квантовой механики, вероятность перехода сквозь барьер треугольной формы, имеет вид:
 E-1), (3.41)
E-1), (3.41)
т.е. вероятность туннелирования экспоненциально растет с увеличением E.
Туннелирование не имеет преимущественного направления, т.е. переходы AàB и BàA равновероятны. Но поскольку концентрация электронов в валентной зоне существенно (на несколько порядков величины) выше, чем в зоне проводимости, то туннелирование происходит преимущественно из валентной зоны в зону проводимости. Особенностью туннелирования является тот факт, что его вероятность не зависит от температуры (формула (3.41)). Вместе с тем, при увеличении температуры туннельный ток растет. Это связано с тем, что с увеличением температуры уменьшается ширина запрещенной зоны и, соответственно, уменьшается ширина туннельного барьера. Аналогичным образом объясняется тот факт, что в полупроводниках с узкой запрещенной зоной вероятность туннелирования выше. Экспериментально установлено, что наступление туннельного эффекта становится заметным при E ~ 107 – 108 В.см.
Эффект туннелирования при пространственном сближении разрешенных зон, используют при формировании полупроводниковых приборов (диодов), стабилизирующих напряжение (стабилитронов). Стабилитроны, использующие туннельный пробой являются низковольтными. Напряжение стабилизации определяется величиной легирования p и n областей p-n-перехода, поскольку и высота потенциального барьера p-n-перехода, и ширина ОПЗ p-n-перехода зависят от уровня легирования. При увеличении температуры ширина запрещенной зоны уменьшается à увеличивается P à туннелирование начинается при более низком обратном смещении на диоде. Следовательно, напряжение стабилизации низковольтного стабилитрона уменьшается с температурой (нарисовать ВАХи).
2. ЭФФЕКТ ГАННА. ПРИНЦИП РАБОТЫ И УСТРОЙСТВО ДИОДОВ ГАННА.
Эффект Ганна был обнаружен в 1963 году сотрудником фирмы IBM Дж.Ганном в GaAs n-типа. В настоящее время он широко используется в полупроводниковой СВЧ-электронике, в частности, для генерирования СВЧ колебаний [1,2,3,4,5].
2.1. Физическая сущность эффекта Ганна.
Сущность эффекта Ганна заключается в возникновении спонтанных осциляций тока (СВЧ-колебаний) в объеме однородного полупроводникового образца приложении к нему постоянного электрического поля, большего некоторого порогового значения (критическое значение поля  = 3,5 кВ/см GaAs и
= 3,5 кВ/см GaAs и  = 6 кВ/см InP).
= 6 кВ/см InP).
Объяснение эффекта было дано на основе механизма междолинного перехода электронов в зоне проводимости (механизм Ридли-Уоткинса-Химпуса), предложенного еще до открытия эффекта. Рассмотрим этот механизм на примере полупроводника, имеющего два минимума (две долины) в зоне проводимости. На рис. 1 схематически представлена структура зоны проводимости GaAs.

Рис.1. Энергетическая диаграмма зоны проводимости GaAs.
При комнатной температуре и слабом электрическом поле практически все электроны будут находиться в нижней долине. Плотность электрического тока, протекающего через образец

| (1) |
где  - заряд электрона,
- заряд электрона,  - концентрация электронов в равновесном состоянии,
- концентрация электронов в равновесном состоянии,  - подвижность электронов, соответствующая нижней долине,
- подвижность электронов, соответствующая нижней долине,  - величина приложенного электрического поля.
- величина приложенного электрического поля.

| (2) |
есть средняя дрейфовая скорость электронов, пропорциональная приложенному полю.
При достаточно большом поле (  ) кинетическая энергия электронов может возрасти больше, чем на
) кинетическая энергия электронов может возрасти больше, чем на  , и они перейдут в верхнюю долину с большем эффективной массой, которой соответствует большая плотность состояний, превышающем значение
, и они перейдут в верхнюю долину с большем эффективной массой, которой соответствует большая плотность состояний, превышающем значение  , почти все электроны будут находиться в верхней долине. Соответственно, средняя дрейфовая скорость станет равной
, почти все электроны будут находиться в верхней долине. Соответственно, средняя дрейфовая скорость станет равной

| (3) |
Когда же поле таково, что часть электронов находится в верхней долине, а часть в нижней, плотность протекающего тока

| (4) |
где  - общее число электронов проводимости, не зависящее от величины поля
- общее число электронов проводимости, не зависящее от величины поля  , а
, а

| (5) |
То есть, при промежуточных значениях электрического поля скорость электронов при  может уменьшаться с увеличением поля, если
может уменьшаться с увеличением поля, если  убывает быстрее, чем
убывает быстрее, чем  . Зависимость скорости электронов от поля
. Зависимость скорости электронов от поля  для GaAs имеет вид, показанный на рис.2.
для GaAs имеет вид, показанный на рис.2.

Рис.2. Зависимость скорости электронов от электрического поля.
Падающему участку данной зависимости соответствует отрицательное дифференциальное сопротивление образца  , которое, как показано, обусловлено механизмом междолинного перехода электронов в зоне проводимости. Наличие отрицательного дифференциального сопротивления согласно общей теории генераторов указывает на возможность генерации электрических колебаний.
, которое, как показано, обусловлено механизмом междолинного перехода электронов в зоне проводимости. Наличие отрицательного дифференциального сопротивления согласно общей теории генераторов указывает на возможность генерации электрических колебаний.
Рассмотренный механизм Ридли-Уоткинса-Хилсума указывает также, что спонтанная осцилляция тока под действием приложенного сильного внешнего поля может быть получена в любом многодолинном полупроводнике, при условии, что долины имеют минимума с разной энергией и соответствующие плотности состояний. Явление междолинного перехода электронов, как указывалось, становится возможным, когда к образцу приложено сильное электрическое поле, которое «разогревает» электроны, увеличивая их кинетическую энергию больше, чем на  . Подвижность же носителей заряда для верхней долины значительно меньше (эффективная масса больше), чем для нижнего минимума (для GaAs, например,
. Подвижность же носителей заряда для верхней долины значительно меньше (эффективная масса больше), чем для нижнего минимума (для GaAs, например,  ,
,  .
.
Следовательно, в том месте образца, где электроны перешли в верхнюю долину, сопротивление становится выше, так как

| (6) |
(  - нижняя, верхняя долина).
- нижняя, верхняя долина).
Центром образования области повышенного сопротивления может стать любая локальная неоднородность в полупроводнике, так как электрическое поле около нее будет несколько больше, чем в однородной части.
Образование области повышенного сопротивления начинается с того, что под действием электрического поля, значение которого около неоднородности выше, электроны, находящиеся вблизи этой неоднородности переходят в более высокоэнергетическое состояние с меньшим значением подвижности  .
.
Поскольку поле внутри этого участка превышает  , скорость электронов в нем уменьшается с дальнейшим увеличением поля в соответствий с зависимостью
, скорость электронов в нем уменьшается с дальнейшим увеличением поля в соответствий с зависимостью  , изображенной на рис.2. Первоначальная область сильного электрического поля станет расширяться за счет того, что к замедлившимся на этом участке электронам, догоняя их, «притекут» электроны из области образца, находящийся между катодом и доменом, и таким образом на заднем фронте образуется избыточный отрицательный заряд. «Легкие» электроны, находящиеся ближе к положительному электроду, будут «убегать» к аноду н на переднем фронте образуется избыточный положительный заряд. Таким образом, объемный заряд области возрастает, возрастает и поле в ней.Образовавшийся дипольный слой называется доменом.
, изображенной на рис.2. Первоначальная область сильного электрического поля станет расширяться за счет того, что к замедлившимся на этом участке электронам, догоняя их, «притекут» электроны из области образца, находящийся между катодом и доменом, и таким образом на заднем фронте образуется избыточный отрицательный заряд. «Легкие» электроны, находящиеся ближе к положительному электроду, будут «убегать» к аноду н на переднем фронте образуется избыточный положительный заряд. Таким образом, объемный заряд области возрастает, возрастает и поле в ней.Образовавшийся дипольный слой называется доменом.
Если приложенное напряжение остается неизменным, то с ростом домена поле вне его будет уменьшаться (  ), уменьшается также и дрейфовая скорость
), уменьшается также и дрейфовая скорость  электронов вне домена. Процесс увеличения объемного заряда, усиления электрического поля внутри домена продолжается до тех пор, пока скорости внутри и вне не станут равными. Причем равенство установится при скорости, меньшей
электронов вне домена. Процесс увеличения объемного заряда, усиления электрического поля внутри домена продолжается до тех пор, пока скорости внутри и вне не станут равными. Причем равенство установится при скорости, меньшей  . После этого сформировавшийся домен сильного электрического поля дрейфует с постоянной скоростью к аноду и исчезает на нем. Затем образуется новый домен и процесс повторяется.
. После этого сформировавшийся домен сильного электрического поля дрейфует с постоянной скоростью к аноду и исчезает на нем. Затем образуется новый домен и процесс повторяется.
В стационарном режиме образуется всегда только один домен. Действительно, в области повышенного сопротивления поле будет больше, чем в однородной части. Поэтому поле вне домена всегда меньше критического  .
.
Обычно формирование домена начинается вблизи катода, так как именно у катода сконцентрированы локальные контактные неоднородности. Если же центром образования области повышенного сопротивления стала неоднородность вблизи анода, то вырасти в домен за время  дрейфа (где
дрейфа (где  - расстояние от неоднородности до анода) эта область не успеет, и неоднородность электрического поля будет снесена на анод электронным потоком. Время формирования домена, возникающего у катода, ограничено большей величиной:
- расстояние от неоднородности до анода) эта область не успеет, и неоднородность электрического поля будет снесена на анод электронным потоком. Время формирования домена, возникающего у катода, ограничено большей величиной:  . Поэтому при наличии контактных неоднородностей их у катода, и у анода центрами образования доменов станут участки повышенного поля именно вблизи катода.
. Поэтому при наличии контактных неоднородностей их у катода, и у анода центрами образования доменов станут участки повышенного поля именно вблизи катода.
При образовании домена плотность тока через образец уменьшается от
 до
до  ,
,
 остается неизменной во время распространения домена образца, и при исчезновении его на аноде плотность тока снова увеличивается до
остается неизменной во время распространения домена образца, и при исчезновении его на аноде плотность тока снова увеличивается до  . Вслед за этим образуется новый домен и цикл повторяется. Таким образом, в цепи, содержащей образец, возникают периодические колебания тока.
. Вслед за этим образуется новый домен и цикл повторяется. Таким образом, в цепи, содержащей образец, возникают периодические колебания тока.
Если время формирования и исчезновения домена значительно меньше времени его пролета вдоль образца (  ), то и период возникающих колебаний тока примерно равен времени пролета
), то и период возникающих колебаний тока примерно равен времени пролета  . Осцилляции тока имеют форму периодических импульсов (рис. 3). Уменьшение тока от максимального
. Осцилляции тока имеют форму периодических импульсов (рис. 3). Уменьшение тока от максимального  до некоторого минимального значения
до некоторого минимального значения  происходит по мере формирования домена. Минимальное значение тока
происходит по мере формирования домена. Минимальное значение тока  остается постоянным, пока домен перемещается к аноду. Распад домена на аноде сопровождается увеличенном тока до
остается постоянным, пока домен перемещается к аноду. Распад домена на аноде сопровождается увеличенном тока до  , после чего основа образуется новый домен. Период колебаний тока
, после чего основа образуется новый домен. Период колебаний тока

Если длина образца  ,
,  , то частота колебаний
, то частота колебаний  .
.

Рис.3. Колебания тока в цепи с диодом Ганна.
2.2. СВЧ-генератор на основе эффекта Ганна.
Прибором, реализующим эффект ганновской генерации, является диод, построенный на основе однородного полупроводникового образца (чаще GaAs). Конструкция ганновского диода представлена на рис. 4.
Рабочая часть диода - пластинка толщиной  10 мкм из однородного GaAs (концентрация носителей заряда
10 мкм из однородного GaAs (концентрация носителей заряда  ). С обеих сторон рабочей части созданы приконтактные
). С обеих сторон рабочей части созданы приконтактные  - области GaAs (концентрация носителей заряда
- области GaAs (концентрация носителей заряда  ) толщиной примерно равной 100 мкм.
) толщиной примерно равной 100 мкм.
Трехслойная полупроводниковая структура (1) помещена в керамический корпус (6). Над одним из приконтактных n+ - слоев создан металлический катодный контакт (2), к которому присоединяются контактные проволочка из золота (3), припаянные к внешнему выводу катода (5). Другой приконтактный  - подложкой полупроводниковая структура присоединена к теплопроводящему медному выводу (7), выполняющему функцию анода.
- подложкой полупроводниковая структура присоединена к теплопроводящему медному выводу (7), выполняющему функцию анода.
Работа генераторного диода непосредственно на включенную последовательно с ним нагрузку имеет очень низкий к.п.д. Существенное увеличение к.п.д. генератора, а также расширение частотного диапазона можно получить, применяя настраиваемую LCR - цепь (колебательный контур). Поскольку чаще диоды Ганна применяются для СВЧ генерации, то такой настраиваемой LCR - цепью является объемный резонатор.
На рис.5 представлена конструкция генератора СВЧ, выполненного по авторскому свидетельству СССР ╧ 608402 и используемого в работе. Генератор СВЧ включает в себя одноволновый прямоугольный резонатор 1, в центре которого установлен диод Ганна 2, подвод постоянного напряжения к диоду осуществляется через анодированный штырь 3, который изолирован по постоянному току от корпуса резонатора. В то же время между штырем 3 и корпусом существует емкость, достаточная для короткого замыкания токов СВЧ. Один конец резонатора коротко замкнут, а на другом выполнено отверстие связи 4 для вывода СВЧ-мощности в нагрузку. Элементом перестройки частоты резонатора являются два равновеликих жестко связанных между собой штыря 5, которые выполнены с возможностью перемещения вдоль своей оси. Так как штыри 5 расположены на расстоянии ?/4 и 3?/4 от короткозамкнутого конца резонатора в пучностях электрической составляющей СВЧ поля, то их перемещение приводит к изменению сосредоточенных емкостей и перестройке генератора. В то же время, из-за того, что штыри 5 перемещаются совместно, структура СВЧ поля в месте расположения диода Ганна не меняется, то есть диод Ганна согласован с резонатором при любом положении штырей при их совместном перемещении. Этим обеспечивается получение высокой генерируемой мощности СВЧ в диапазоне рабочих частот генератора.

Рис.4. Конструкция диода Ганна.

Рис.5. Генератор на основе диода Ганна.
2.3. Режимы генерации.
Работая в разных резонаторах, один и тот же диод генерирует в диапазоне частот от 0 до 100 ГГц. Этому огромному диапазону соответствует несколько режимов работы, причем природа отрицательного дифференциального сопротивления, вносимого диодом в контур, различна в разных режимах.
К диоду, работающему в резонаторе, приложено кроме постоянного электрического поля смещения также СВЧ поле за счет колебаний протекающего через диод тока. Форма колебаний СВЧ тока определяется типом LCR - контура (параллельный, последовательный или др.). В случае, когда к диоду приложено синусоидальное СВЧ-напряжение, возможны следующие режимы: пролетный, запаздывающий, режим гашения, гибридный, режим ограничения накопления пространственного заряда (ОНОЗ), многодоменный режим генерации.
Пролетный режим колебаний осуществляется, когда амплитуда переменного поля  мала по сравнению с разностью
мала по сравнению с разностью  , где
, где  - постоянное поле смещения. СВЧ поле при этом практически не меняет форму колебаний тока. Режим ничем не отлича-ется от работы диода на резистивную нагрузку. К.п.д. генератора в этом режиме составляет доли процента.
- постоянное поле смещения. СВЧ поле при этом практически не меняет форму колебаний тока. Режим ничем не отлича-ется от работы диода на резистивную нагрузку. К.п.д. генератора в этом режиме составляет доли процента.
Запаздывающий режим реализуется, если амплитуда СБЧ поля возрастает настолько, что выполняется условие :  , где
, где  - значение поля, при котором домен исчезает. Поле, приложенное к образцу, в момент, когда домен распадается, достигнув анода, оказывается меньше порогового
- значение поля, при котором домен исчезает. Поле, приложенное к образцу, в момент, когда домен распадается, достигнув анода, оказывается меньше порогового  , и новый домен не может образоваться. Образец, таким образом, является омическим сопротивлением, пока поле не станет равным
, и новый домен не может образоваться. Образец, таким образом, является омическим сопротивлением, пока поле не станет равным  («режим с запаздывающим формированием домена»). Частота в этом режиме меньше, чем в пролетном, и может быть перестроена изменением собственной частоты резонатора.
(«режим с запаздывающим формированием домена»). Частота в этом режиме меньше, чем в пролетном, и может быть перестроена изменением собственной частоты резонатора.
С дальнейшим повышением амплитуды. СВЧ поля, при  домен исчезает, не достигнув анода, в момент, когда суммарное поле на диоде становится равным
домен исчезает, не достигнув анода, в момент, когда суммарное поле на диоде становится равным  . Этот режим называется «режимом с подавлением домена» (режим гашения). Частота колебаний может быть меньше или больше пролетной.
. Этот режим называется «режимом с подавлением домена» (режим гашения). Частота колебаний может быть меньше или больше пролетной.
Когда частота резонатора становится порядка обратного време-ни формирования домена, при условии подавления  реализуется гибридный режим. Домен распадается, не сформировавшись окончательно. Этот режим наиболее эффективен в области частот до 10 ГГц.
реализуется гибридный режим. Домен распадается, не сформировавшись окончательно. Этот режим наиболее эффективен в области частот до 10 ГГц.
Если частота резонатора намного больше обратного времени формирования домена, осуществляется режим ОНОЗ. Домены при этом не успевают формироваться, и зависимость тока от поля совпадает с зависимостью  . Частоты, на которых наиболее эффективен режим ОНОЗ, превышают 10 ГГц, так как в этом режиме нет ограни-чений, связанных и со временем образования домена, и со временем его пролета. Максимальная частота, достигаемая при этом режиме, 160 ГГц.
. Частоты, на которых наиболее эффективен режим ОНОЗ, превышают 10 ГГц, так как в этом режиме нет ограни-чений, связанных и со временем образования домена, и со временем его пролета. Максимальная частота, достигаемая при этом режиме, 160 ГГц.
2.4. Вольтамперная характеристика диода Ганна.
Исходя из вышеизложенного, можно нарисовать следующую идеализированную картину эффекта Ганна. Практически вплоть до порогового поля ганновских осцилляции выполняется закон Ома, и ВАХ определяется выражением

| (7) |
Для всех практически важных случаев пороговое поле равно  , соответствующему максимуму характеристики скорость-поле. С возникновением доменов плотность тока в диоде колеблется от значения
, соответствующему максимуму характеристики скорость-поле. С возникновением доменов плотность тока в диоде колеблется от значения  (без домена) до
(без домена) до  (с доменом). Таким образом, средняя во времени вольтамперная характеристика диода для идеализированной картины, эффекта имеет вид, представленный на рис.6.
(с доменом). Таким образом, средняя во времени вольтамперная характеристика диода для идеализированной картины, эффекта имеет вид, представленный на рис.6.
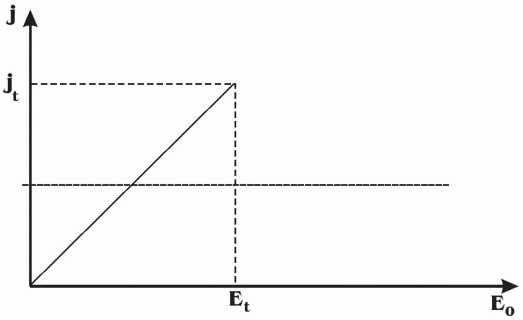
Рис.6. Идеализированная вольтамперная характеристика диода Ганна.
Но идеальная картина наблюдается редко, на отдельных приборах. Качественные отклонения от нее связаны с влиянием на эффект Ганна неоднородностей и контактов, свойства которых определяются технологическими факторами, такими, как материал контактов, условия его нанесения и т.д. Все это меняет и картину эффекта, и ВАХ диода. ВАХ реального диода показана на рис.7. Предположим, что диод Ганна, обладающий вольтамперной характеристикой с участком ОДП (рис.7.) помещен в СВЧ-резонатор. Рассмотрим, каким образом параметры реальной ВАХ определяют его СВЧ-свойства.

Рис.7. ВАХ реального диода.
Величина генерируемой диодом мощности определяется выраженим:

| (8) |
где  - амплитуда первой гармоники тока;
- амплитуда первой гармоники тока;  - амплитуда СВЧ напряжения.
- амплитуда СВЧ напряжения.
Для  (
(  - рабочее напряжение,
- рабочее напряжение,  - пороговое)
- пороговое)  , т.к. в некоторую часть периода суммарное напряжение меньше
, т.к. в некоторую часть периода суммарное напряжение меньше  . Величина амплитуды тока
. Величина амплитуды тока  определяется параметрами ВАХ диода:
определяется параметрами ВАХ диода:

| (9) |
где  - коэффициент, определяемый формой колебаний тока (зависит от согласования диода с резонатором),
- коэффициент, определяемый формой колебаний тока (зависит от согласования диода с резонатором),  - максимальный ток через диод,
- максимальный ток через диод,  - рабочий ток.
- рабочий ток.
Величина  - это мощность, выделяемая на клеммах диода. В нагрузку (на детектор) поступает лишь часть ее:
- это мощность, выделяемая на клеммах диода. В нагрузку (на детектор) поступает лишь часть ее:

| (10) |
где  - к.п.д. резонатора.
- к.п.д. резонатора.
Таким образом, мощность, выделяемая в нагрузке, определяется как параметрами диода Ганна (  ), так и параметром резонатора
), так и параметром резонатора  - так назывемым коэффициентом потерь резонатора. Приведенное выше выражение (10) определяет связь СВЧ-параметра диода (
- так назывемым коэффициентом потерь резонатора. Приведенное выше выражение (10) определяет связь СВЧ-параметра диода (  ) с его статистическими параметрами (с ВАХ) и используется для прогнозирования величины мощности генерации по измерениям параметра ВАХ
) с его статистическими параметрами (с ВАХ) и используется для прогнозирования величины мощности генерации по измерениям параметра ВАХ  .
.
Из независимого измерения  и
и  на одном диоде определяется
на одном диоде определяется  данного резонатора, а для остальных диодов проводятся измерения с последующим расчетом по формуле (10) (а. с. СССР ╧ 991827).
данного резонатора, а для остальных диодов проводятся измерения с последующим расчетом по формуле (10) (а. с. СССР ╧ 991827).
3. ОПИСАНИЕ И РАБОТА УСТАНОВКИ.
Установка предназначена для автоматической записи вольтамперных характеристик генераторных диодов и измерения величины генерируемой диодом мощности. На панели установки (рис.9) расположены: индикаторная лампочка включения сети, ручки управления установкой,

Рис.9. Передняя панель установки.
стрелочные измерительные приборы. В правой части панели расположены ручки управления:
- тумблер «Запись-возврат», обеспечивающий включение и выключение развертки при записи ВАХ на двухкоординатном самописце;
- ручка «Амплитуда» 7, регулирующая максимальное напряжение развертки;
- ручка «Скорость записи», регулирующая время заряда 5 и время разряда 6 конденсатора при записи ВАХ, обеспечивающий нужную скорость записи;
- тумблер «Сеть» расположен на левой боковой стенке установки;
- выходные гнезда для записи ВАХ на самописце - на задней панели.
На панели измерительных приборов установки расположены:
- слева - миллиамперметр, измеряющий ток через диод Ганна (шкала 300 мА);
- в центре - вольтметр для измерения подаваемого на диод Ганна постоянного напряжения (шкала 10В);
- справа - миллиамперметр для измерения тока детектора СБЧ (шкала 1,25 мА).
СВЧ-тракт установки включает в себя:
- СВЧ - генератор с установленным в нем диодом Ганна (АА703Б);
- измерительный аттенюатор;
- детекторную секцию.
Функциональная схема установки приведена на рис.8.
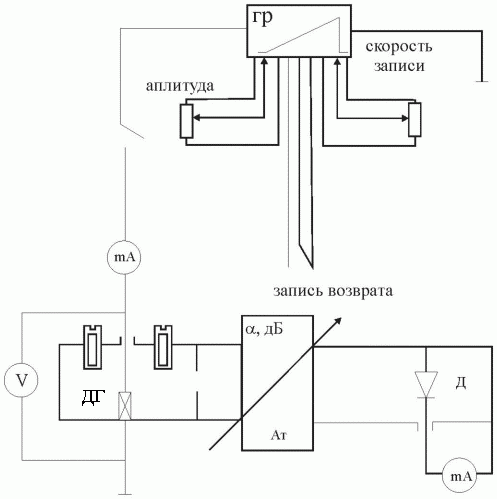
Рис.8. Функциональная схема установки: ДГ - диод Ганна, ГР - генератор развертки, Д - детекторный диод, Ат - аттенюатор.
Измерение генерируемой мощности проводятся при помощи измерительного аттенюатора и детектора. Подводимая к детектору СВЧ мощность величиной 1мВт обеспечивает ток детектора 1мА. Таким образом, измеряя ослабление  при токе детектора 1мА из формулы
при токе детектора 1мА из формулы

| (11) |
можно вычислить генерируемую диодом мощность СВЧ (  ) (
) (  =1мВт).
=1мВт).
В 1963 г. Джон Ганн, изучая поведение арсенида галлия в области сильных полей, обнаружил новое явление, заключающееся в возникновении колебаний тока с частотой  Гц при приложении к кристаллу постоянного электрического поля. Этот эффект наблюдали позднее и в фосфиде индия.
Гц при приложении к кристаллу постоянного электрического поля. Этот эффект наблюдали позднее и в фосфиде индия.
В основе эффекта Ганна лежит междолинное рассеяние носителей заряда. Что такое междолинное рассеяние? Это рассеяние (т.е. изменение состояния электрона) сопровождающееся перебросом электронов из одного минимума зоны проводимости (из основной долины) в другой минимум (в сателлитную долину). Необходимым условием такого перехода является наличие нескольких минимумов зоны проводимости (долин).
Рассмотрим зонную структуру арсенида галлия. Зависимость энергии электрона в зоне проводимости от волнового вектора k имеет вид, представленный на рис. 3.16. Существенными являются следующие моменты:
- зона проводимости имеет два минимума (А и Б), которые разделены энергетическим зазором DE=0.36 эВ;
- кривизна дисперсионной поверхности E(k) в области этих двух экстремумов различна, поэтому различаются и эффективные массы электронов, находящиеся в этих минимумах;
- в центральной долине А электроны имеют меньшую эффективную массу (  ), чем в сателлитной долине Б, в которой электроны существенно более тяжелые (
), чем в сателлитной долине Б, в которой электроны существенно более тяжелые (  ).
).

| 
|
| Рис. 3.16. Схема зон в n-GaAs: 1, А – нижняя долина, 2, Б – верхняя долина, 3 – зона проводимости, 4 – валентная зона | Рис. 3.17. Распределение электронов при различных значениях E. |
Подвижность электронов связана с их эффективной массой известным соотношением  , следовательно, подвижность лёгких электронов выше, чем тяжёлых. В случае GaAs – подвижность лёгких электронов составляет 4000- 8000 см2/В∙с, тогда как подвижность тяжёлых – около 100-200 см2/В∙с. Поэтому следует ожидать, что при переходе электронов из долины А в долину Б, их подвижность уменьшается.
, следовательно, подвижность лёгких электронов выше, чем тяжёлых. В случае GaAs – подвижность лёгких электронов составляет 4000- 8000 см2/В∙с, тогда как подвижность тяжёлых – около 100-200 см2/В∙с. Поэтому следует ожидать, что при переходе электронов из долины А в долину Б, их подвижность уменьшается.
Рассмотрим действие электрического поля на носители заряда. При слабых внешних электрических полях электроны будут находиться в термодинамическом равновесии с решёткой, имеющей температуру Т0. При kT0<<ΔE электроны занимают энергетические уровни в нижней энергетической долине А. В этом случае плотность тока определяется концентрацией  и подвижностью μА лёгких электронов в соответствии с формулой Jn = qnμA E. При этом, скорость движения электронов, а значит и плотность тока, будут линейно возрастать с ростом напряжённости поля до некоторого критического значения.
и подвижностью μА лёгких электронов в соответствии с формулой Jn = qnμA E. При этом, скорость движения электронов, а значит и плотность тока, будут линейно возрастать с ростом напряжённости поля до некоторого критического значения.
При достижении первой критической величины Eа, средняя энергия электронов повышается и становится возможным переход электронов в верхнюю долину Б, где они имеют большую эффективную массу, меньшую подвижность и высокую плотность состояний. Таким образом, с ростом напряжённости поля (от Eа до Eб – рис. 3.17) имеет место уменьшение подвижности электронов, и, следовательно, уменьшение плотности тока. На вольт-амперной характеристике появляется падающий участок рис. 3.18.
При E > Eб значительная часть электронов переходит в верхнюю долину, где они обладают большой массой. В этом случае подвижность электронов, а, следовательно, и скорость движения электронов резко падают, и плотность тока следует закономерности: JБ=q∙n0∙μБ∙E (рис.3.18). Таким образом, график зависимости скорости движения электронов от напряжённости поля, а также на ВАХ имеют вид N-образной зависимости с ниспадающим участоком в интервале Eа < E < Eб; такая особенность ВАХ приводит к неустойчивостям и генерации импульсов тока.

| 
|
| Рис. 3.18. Зависимость плотности тока от напряженности электрического поля для двухдолинного полупроводника. | Рис. 3.19. Распределение электрического поля (а) и плотности электронов (б) вдоль образца в случае стабильного домена, движущегося со скоростью vд. |
Рассмотрим более подробно механизм электронной неустойчивости, приводящей к высокочастотным осцилляциям тока. Пусть к образцу длинной L приложено внешнее электрическое поле. В однородном полупроводнике электрическое поле распределено примерно одинаково по всей длине. Однако если в образце присутствуют неоднородности структуры или состава, имеющие локально-увеличенное сопротивление, то напряжённость электрического поля в этом локальном месте образца будет существенно выше. Как следствие, при увеличении среднего уровня напряжённости поля, критическое значение Eкр достигается в первую очередь в области расположения дефектов (повышенного сопротивления). Как только напряжённость поля достигнет Eкр, происходит переход электронов в верхнюю долину, концентрация тяжёлых электронов возрастаеть. В этом случае локальная (в области дефекта) плотность тока может быть записана в виде:
J = q∙nА∙μА∙E+q∙nБ∙μБ∙E = σ∙E =1/ρ∙E

Поскольку общая концентрация носителей заряда неизменна, то удельное сопротивление (r), возрастает. Это приводит к возрастанию напряжённости поля в этом месте образца, что в свою очередь вызывает более интенсивный переход электронов в верхние минимумы. Справа и слева от этой области напряжённость поля будет падать, и распределение поля становится резко неоднородным. Такая область с сильным электрическим полем получило название электрического домена.
Домен, содержащий тяжёлые электроны, под действием поля перемещается вдоль образца с относительно низкой скоростью, т.к. подвижность тяжёлых электронов мала. Лёгкие электроны также перемещаются в поле, причём с большей скоростью. Те электроны, которые движутся сзади домена, догоняют его, попадают в область высокого поля, уменьшают скорость и, тем самым, увеличивают область отрицательного объёмного заряда Те же электроны, которые движутся впереди, уходят от домена, что приводит к формированию области, обеднённой электронами т.е. области положительного объёмного заряда (рис. 3.19).
Через некоторое время устанавливается новое стационарное состояние, при котором скорость движения домена выравнивается со скоростью перемещения электронов вне домена. Это происходит в силу следующих причин. С одной стороны, что поле внутри домена возрастает настолько сильно, что приводит к повторному увеличению скорости движения «медленных» электронов в домене (см. область E >> EБ на рис. 3.18). С другой стороны, поскольку средняя величина поля по всему образцу постоянна, а поле внутри домена увеличивается, поэтому поле вне домена резко снижается, что приводит к уменьшению дрейфовой скорости «быстрых» электронов за пределами домена. В таком стационарном состоянии домен передвигается вдоль образца к катоду. Когда домен достигает границы образца (катода), он разрушается.
Рассмотрим изменение среднего тока через образец (на контактах). Пусть внешнее напряжение прикладывается к образцу в момент времени  . Практически сразу после достижения номинального значения напряжения, на одной из структурных неоднородностей образца начинается образование домена. Этот процесс протекает очень быстро, т.к. постоянная времени, связанная с переходом электронов из минимума А в Б составляет менее 10
. Практически сразу после достижения номинального значения напряжения, на одной из структурных неоднородностей образца начинается образование домена. Этот процесс протекает очень быстро, т.к. постоянная времени, связанная с переходом электронов из минимума А в Б составляет менее 10  сек. Сила тока резко понижается до значения Imin, определяемого скоростью движения домена:
сек. Сила тока резко понижается до значения Imin, определяемого скоростью движения домена:
 , где S- площадь сечения образца.
, где S- площадь сечения образца.
Это значение тока сохраняется до тех пор, пока домен не разрушится на границе образца. Очевидно, что время движения домена: t = L/vD. После достижения катода домен начинает разрушаться, и ток возрастает до
|
из
5.00
|
Обсуждение в статье: Электростатическая ионизация |
|
Обсуждений еще не было, будьте первым... ↓↓↓ |

Почему 1285321 студент выбрали МегаОбучалку...
Система поиска информации
Мобильная версия сайта
Удобная навигация
Нет шокирующей рекламы

